Power Dissipation
Table 4. MPC860 Thermal Resistance Data
ZP
ZQ / VR
Unit
Rating
Environment
Symbol
MPC860P MPC860P
Mold Compound Thickness
0.85
34
22
27
18
14
6
1.15
34
22
27
18
13
8
mm
1
2
Junction-to-ambient
Natural convection
Single-layer board (1s)
RθJA
°C/W
3
Four-layer board (2s2p)
Single-layer board (1s)
Four-layer board (2s2p)
RθJMA
3
Airflow (200 ft/min)
RθJMA
3
RθJMA
4
Junction-to-board
RθJB
RθJC
ΨJT
5
Junction-to-case
6
Junction-to-package top Natural convection
2
2
1
Junction temperature is a function of on-chip power dissipation, package thermal resistance, mounting site (board)
temperature, ambient temperature, air flow, power dissipation of other components on the board, and board thermal
resistance.
2
3
4
Per SEMI G38-87 and JEDEC JESD51-2 with the single layer board horizontal.
Per JEDEC JESD51-6 with the board horizontal.
Thermal resistance between the die and the printed circuit board per JEDEC JESD51-8. Board temperature is measured
on the top surface of the board near the package.
5
Indicates the average thermal resistance between the die and the case top surface as measured by the cold plate
method (MIL SPEC-883 Method 1012.1) with the cold plate temperature used for the case temperature. For exposed pad
packages where the pad would be expected to be soldered, junction-to-case thermal resistance is a simulated value from
the junction to the exposed pad without contact resistance.
6
Thermal characterization parameter indicating the temperature difference between the package top and the junction
temperature per JEDEC JESD51-2.
5 Power Dissipation
Table 5 provides power dissipation information. The modes are 1:1, where CPU and bus speeds are equal, and 2:1,
where CPU frequency is twice the bus speed.
Table 5. Power Dissipation (PD)
1
2
Die Revision
Frequency (MHz) Typical
Maximum
Unit
D.4
50
66
66
80
656
TBD
722
851
735
TBD
762
909
mW
mW
mW
mW
(1:1 mode)
D.4
(2:1 mode)
1
2
Typical power dissipation is measured at 3.3 V.
Maximum power dissipation is measured at 3.5 V.
NOTE
-based power dissipation and do not include I/O
Values in Table 5 represent V
DDL
power dissipation over V
. I/O power dissipation varies widely by application
DDH
due to buffer current, depending on external circuitry.
MPC860 Family Hardware Specifications, Rev. 7
Freescale Semiconductor
7






 NTC热敏电阻与PTC热敏电阻的应用原理及应用范围
NTC热敏电阻与PTC热敏电阻的应用原理及应用范围

 GTO与普通晶闸管相比为什么可以自关断?为什么普通晶闸管不能呢?从GTO原理、应用范围带你了解原因及推荐型号
GTO与普通晶闸管相比为什么可以自关断?为什么普通晶闸管不能呢?从GTO原理、应用范围带你了解原因及推荐型号

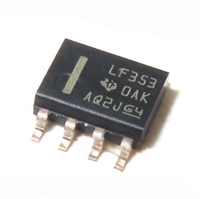 LF353数据手册解读:特性、应用、封装、引脚说明、电气参数及替换型号推荐
LF353数据手册解读:特性、应用、封装、引脚说明、电气参数及替换型号推荐

 A4950资料手册解读:特性、应用、封装、引脚功能、电气参数及代换型号
A4950资料手册解读:特性、应用、封装、引脚功能、电气参数及代换型号
