当智能手机因高温降频卡顿,当5G基站因散热不足被迫限速,热管理技术正成为制约电子产业发展的隐形瓶颈。中国科学院上海微系统与信息技术研究所联合宁波大学团队的最新研究成果,或许将彻底改变这一局面——他们以芳纶膜为前驱体,成功制备出兼具超高面内与面外导热性能的石墨膜,为高功率电子器件装上了"双向导热引擎"。这项发表于《Advanced Functional Materials》的研究显示,新型石墨膜在40微米厚度下创造了1754W/m·K的面内热导率(Kin)和14.2W/m·K的面外热导率(Kout)双重纪录。相较于传统导热材料,其突破性在于同时实现了三个维度的性能飞跃:晶粒尺寸较常规产品扩大50%以上,缺陷密度降低两个数量级,氮掺杂工艺使碳原子排列取向度提升至近完美水平。这种"低缺陷、大晶粒、高取向"的三元协同效应,让热量能像高速公路上的车流般双向快速传导。
在实际应用测试中,该材料展现出惊人的散热效能。智能手机模拟实验显示,搭载新型石墨膜的芯片表面最高温度从52℃直降至45℃,相当于延长了芯片20%的使用寿命;更令人惊叹的是,在2000W/cm²的超高热流密度环境下(相当于火箭尾焰的热冲击强度),材料使芯片表面温差从50℃骤降至9℃,温度均匀化速度提升5倍以上。这种"秒级均温"特性,恰好解决了5G基站功率放大器、电动汽车IGBT模块等场景中局部热点导致系统失效的痛点。

研究团队首次揭示了芳纶前驱体的四大优势:分子链固有的高取向性为石墨化提供了理想模板,氮元素的自掺杂作用修复了晶格缺陷,低氧含量抑制了高温处理时的结构畸变,而芳纶的柔性特质则允许制备超薄导热膜。这些发现颠覆了业界对聚酰亚胺等传统前驱体的依赖,开辟了"有机高分子精准调控无机材料性能"的新范式。
目前,该技术已进入中试阶段。据估算,若在5G毫米波芯片中全面应用,可使基站功耗降低15%,相当于单个基站年省电费超万元。随着第三代半导体材料向大功率、微型化发展,这种能"立体导热的石墨烯"或将成为未来电子设备的标配散热方案,其潜在市场规模到2025年预计突破百亿元。这项从分子设计到产业应用的全链条创新,不仅标志着我国在高端导热材料领域实现从跟跑到领跑的跨越,更将为"东数西算"工程、新能源汽车等国家战略提供关键材料支撑。


 891
891







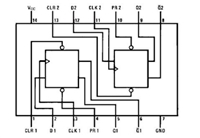




 浙公网安备 33010502006866号
浙公网安备 33010502006866号