当全球半导体行业仍在为ASML的高数值孔径EUV光刻机疯狂投入时,英特尔一位匿名总监却抛出了一个颠覆性观点:未来芯片制造将不再完全依赖这些价值数十亿元的"印钞机"。这场关于光刻技术与刻蚀工艺孰轻孰重的争论,正在重新定义摩尔定律的演进路径。
据投资研究平台Tegus披露的内部讨论内容,这位英特尔技术负责人明确指出,随着GAAFET(全环绕栅极场效应晶体管)和CFET(互补场效应晶体管)等三维结构的普及,芯片制造的核心将从光刻环节转向刻蚀工艺。这种转变的本质,是从平面微缩转向立体构建的技术革命。传统FinFET结构依赖光刻机不断缩小晶体管间距,而新型三维结构则通过垂直堆叠和全方位包裹栅极来实现密度提升。

目前最先进的High NA EUV光刻机确实展现了惊人性能。ASML的EXE:5000系统分辨率达8nm,单次曝光晶体管密度提升2.9倍,每小时可处理400-500片晶圆,效率是标准EUV设备的2倍以上。英特尔已在俄勒冈州工厂安装两台该设备,早期测试显示其能将原本需要三次曝光、40道工序的流程简化为单次曝光和个位数步骤。但这位总监认为,这些优势在未来可能变得"过度设计"。
光刻与刻蚀的技术分野正在重构。光刻如同在晶圆上"绘制蓝图",决定电路的最小特征尺寸;刻蚀则是"精雕细琢",将平面图案转化为立体结构。在三维晶体管时代,如何从各个方向精确去除材料变得比单纯缩小线宽更重要。GAAFET要求栅极360度包裹沟道,CFET更需要垂直堆叠晶体管组,这些突破都依赖于原子级精度的刻蚀技术,而非光刻分辨率的极限突破。
行业观察人士指出,这种技术路线的转变暗合多重现实考量。EUV设备不仅面临地缘政治风险,其超10亿元的单台成本及高昂的掩膜版、光刻胶配套支出,已形成巨大的产业门槛。中国半导体企业被迫发展的多重曝光等替代方案,客观上加速了"去EUV化"技术探索。这让人联想到当年液晶技术取代CRT显示器的产业剧变——看似牢不可破的技术霸权,可能被更经济的新方案颠覆。
这场技术路线的较量远非非此即彼的选择。短期内,High NA EUV仍是2nm及以下制程的主流方案,但英特尔高管的预言揭示了一个重要趋势:半导体行业正在从"光刻决定论"走向"立体集成"的新纪元。当芯片制造不再执着于平面微缩的极限挑战,摩尔定律或许能以更低的成本延续生命力。这场静悄悄的技术革命,终将重塑价值数千亿美元的半导体设备市场格局。











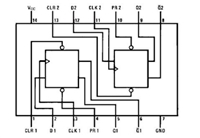




 浙公网安备 33010502006866号
浙公网安备 33010502006866号