当全球AI算力竞赛进入白热化阶段,芯片封装技术正成为决定性能天花板的关键变量。台积电最新曝光的CoPoS封装技术路线图显示,这项革命性创新将于2028年末进入量产阶段,而站在技术风口等待的,正是GPU巨头英伟达。
封装技术革命:从晶圆到面板的跨越 传统CoWoS封装技术面临物理尺寸限制的瓶颈,而CoPoS的突破性在于将中介层从圆形晶圆转变为310x310mm的矩形面板基板。这种"面板化"设计不仅是尺寸的简单扩大,更是封装架构的根本重构。相比现有技术,新方案可容纳更多HBM高带宽存储芯片与计算核心的协同封装,这对需要处理海量数据的AI加速芯片至关重要。
技术路线图浮出水面 台积电已制定清晰的商业化路径:2026年建立试点产线,2027年进行工艺优化调试,最终在嘉义AP7工厂实现2028年末的量产目标。这座被选中的生产基地凭借其现代化设施和充足空间,将成为台积电对抗三星FOPLP技术的战略要塞。值得注意的是,中介层材料从硅到玻璃的迭代,预计将带来15%以上的热稳定性提升,这对高功耗的GPU芯片组尤为关键。
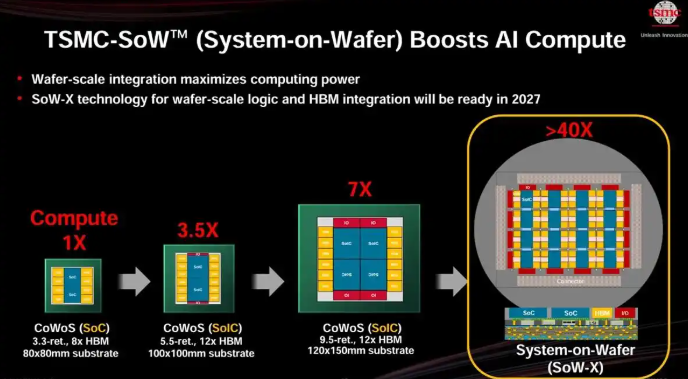
与FOPLP的技术博弈 虽然同属面板级封装,CoPoS与三星主导的FOPLP存在本质差异。前者通过保留中介层结构,在信号完整性和供电稳定性方面具备明显优势,特别适合英伟达这类需要集成数千个计算单元的高端GPU。而FOPLP凭借省略中介层的设计,在中低端移动芯片市场更具成本优势。这种技术路线的分化,预示着未来封装领域可能形成"高端看台积电,中低端看三星"的竞争格局。
英伟达的必然选择 黄仁勋此前"别无选择"的表态,揭示了英伟达对台积电封装技术的深度依赖。随着AI模型参数呈指数级增长,H100后续产品对封装密度的要求将更为严苛。CoPoS提供的超大封装面积和玻璃中介层特性,恰好能满足下一代Blackwell架构GPU的集成需求。供应链消息显示,英伟达已参与该技术的早期验证,这为其争取首发客户地位奠定基础。
这场封装技术的军备竞赛,背后是万亿级AI芯片市场的争夺。台积电通过CoPoS技术不仅巩固了其在先进制程的领先地位,更在封装领域构建起新的技术护城河。当2028年量产钟声敲响时,全球AI算力格局或将迎来新一轮洗牌。




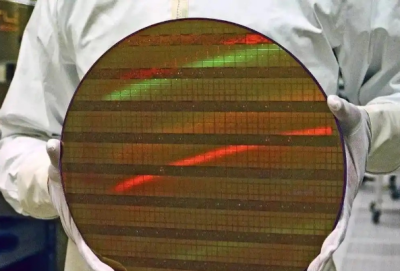






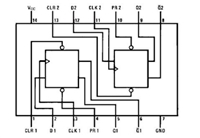




 浙公网安备 33010502006866号
浙公网安备 33010502006866号