在AI与高性能计算需求爆发的今天,芯片封装技术正成为决定算力天花板的关键因素。日月光集团最新发布的FOCoS-Bridge TSV技术,以革命性的硅通孔设计,将多芯片互联性能推向新高度。这项突破性技术如何改写半导体封装规则?
突破传统限制的封装革命
日月光FOCoS-Bridge TSV技术是2.5D封装领域的重大进化,通过在基板上嵌入独立硅桥芯片,构建高密度铜连接层,实现多达10颗小芯片的高速互联。其核心创新在于TSV(硅通孔)技术的引入,相较于原版FOCoS-Bridge,电阻和电感分别降低72%和50%,数据传输路径更短,I/O密度更高。
这一技术的精妙之处在于其"桥梁式"设计——先放置专用互联硅晶芯片,再通过倒装工艺将ASIC处理器与HBM内存精准对接。测试表明,仅47x31mm的封装单元就可集成1颗ASIC和4颗HBM,而双单元并排封装后更可形成包含2颗ASIC、4颗HBM和8片互联硅晶的超级芯片。

三大技术优势定义行业新标准
FOCoS-Bridge TSV最引人瞩目的突破在于其惊人的性能提升。凭借TSV提供的垂直电力传输路径,信号传输效率大幅提高,同时散热效能显著优化,完美适配AI和HPC应用对带宽与速度的严苛要求。日月光研发处长李德章强调:"这项技术实现了SoC与小芯片与HBM的无缝整合"。
成本优势同样突出。相比传统2.5D封装,该技术摆脱了网格尺寸限制,却保持着同等的电气性能。更关键的是,其线密度比有机芯片倒装封装高出整整一个数量级,这意味着在相同面积内可集成更多功能单元。值得注意的是,该技术预留了嵌入有源/无源元件的接口,支持直接访问内存和I/O,为未来封装创新奠定基础。
重塑算力格局的产业影响
作为日月光VIPack平台的重要组成部分,FOCoS-Bridge TSV与台积电CoWoS-L、英特尔EMIB形成技术对标,但凭借其独特的TSV优势占据性能制高点。在AI芯片需求呈指数级增长的背景下,这项技术为异构集成提供了更灵活的解决方案。
业内人士分析,FOCoS-Bridge TSV将首先应用于高端AI加速器和超级计算机领域。其突破性的电阻降低和散热表现,特别适合处理大模型训练中的密集型计算任务。随着技术成熟,预计将逐步向消费级芯片渗透,推动整个半导体产业向更高集成度迈进。
这场由日月光引领的封装革命,不仅解决了多芯片互联的瓶颈问题,更重新定义了算力密度的可能性边界。当TSV技术与硅桥设计相遇,芯片封装的未来图景正变得愈发清晰——更高、更快、更强的时代已经到来。











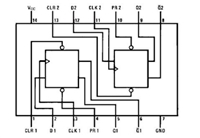




 浙公网安备 33010502006866号
浙公网安备 33010502006866号