HMC449
v01.1007
GaAs MMIC x2 ACTIVE FREQUENCY
MULTIPLIER, 27 - 33 GHz OUTPUT
Mounting & Bonding Techniques for Millimeterwave GaAs MMICs
The die should be attached directly to the ground plane eutectically or with
conductive epoxy (see HMC general Handling, Mounting, Bonding Note).
0.102mm (0.004”) Thick GaAs MMIC
2
50 Ohm Microstrip transmission lines on 0.127mm (5 mil) thick alumina thin film
substrates are recommended for bringing RF to and from the chip (Figure 1). If
0.254mm (10 mil) thick alumina thin film substrates must be used, the die should
be raised 0.150mm (6 mils) so that the surface of the die is coplanar with the
surface of the substrate. One way to accomplish this is to attach the 0.102mm
(4 mil) thick die to a 0.150mm (6 mil) thick molybdenum heat spreader (moly-tab)
which is then attached to the ground plane (Figure 2).
Wire 3 mil Ribbon Bond
0.076mm
(0.003”)
RF Ground Plane
Microstrip substrates should be brought as close to the die as possible in order
to minimize ribbon bond length. Typical die-to-substrate spacing is 0.076mm (3
mils). Gold ribbon of 0.075 mm (3 mil) width and minimal length <0.31 mm (<12
mils) is recommended to minimize inductance on RF, LO & IF ports.
0.127mm (0.005”) Thick Alumina
Thin Film Substrate
An RF bypass capacitor should be used on the Vdd input. A 100 pF single layer
capacitor (mounted eutectically or by conductive epoxy) placed no further than
0.762mm (30 Mils) from the chip is recommended.
Figure 1.
Handling Precautions
0.102mm (0.004”) Thick GaAs MMIC
Follow these precautions to avoid permanent damage.
Ribbon Bond
Storage: All bare die are placed in either Waffle or Gel based ESD protective
containers, and then sealed in an ESD protective bag for shipment. Once the
sealed ESD protective bag has been opened, all die should be stored in a dry
nitrogen environment.
0.076mm
(0.003”)
Cleanliness: Handle the chips in a clean environment. DO NOT attempt to clean
the chip using liquid cleaning systems.
RF Ground Plane
Storage: All bare die are placed in either Waffle or Gel based ESD protective
containers, and then sealed in an ESD protective bag for shipment. Once the
sealed ESD protective bag has been opened, all die should be stored in a dry
nitrogen environment.
0.150mm (0.005”) Thick
Moly Tab
0.254mm (0.010”) Thick Alumina
Thin Film Substrate
Static Sensitivity: Follow ESD precautions to protect against ESD strikes.
Figure 2.
Transients: Suppress instrument and bias supply transients while bias is applied.
Use shielded signal and bias cables to minimize inductive pick-up.
General Handling: Handle the chip along the edges with a vacuum collet or with a sharp pair of bent tweezers. The surface of the
chip may have fragile air bridges and should not be touched with vacuum collet, tweezers, or fingers.
Mounting
The chip is back-metallized and can be die mounted with AuSn eutectic preforms or with electrically conductive epoxy. The
mounting surface should be clean and flat.
Eutectic Die Attach: A 80/20 gold tin preform is recommended with a work surface temperature of 255 deg. C and a tool temperature
of 265 deg. C. When hot 90/10 nitrogen/hydrogen gas is applied, tool tip temperature should be 290 deg. C. DO NOT expose the
chip to a temperature greater than 320 deg. C for more than 20 seconds. No more than 3 seconds of scrubbing should be required
for attachment.
Epoxy Die Attach: Apply a minimum amount of epoxy to the mounting surface so that a thin epoxy fillet is observed around the
perimeter of the chip once it is placed into position. Cure epoxy per the manufacturer’s schedule.
Wire Bonding
Ball or wedge bond with 0.025mm (1 mil) diameter pure gold wire. Thermosonic wirebonding with a nominal stage temperature of
150 deg. C and a ball bonding force of 40 to 50 grams or wedge bonding force of 18 to 22 grams is recommended. Use the minimum
level of ultrasonic energy to achieve reliable wirebonds. Wirebonds should be started on the chip and terminated on the package or
substrate. All bonds should be as short as possible <0.31mm (12 mils).
For price, delivery, and to place orders, please contact Hittite Microwave Corporation:
20 Alpha Road, Chelmsford, MA 01824 Phone: 978-250-3343 Fax: 978-250-3373
Order On-line at www.hittite.com
2 - 37






 NTC热敏电阻与PTC热敏电阻的应用原理及应用范围
NTC热敏电阻与PTC热敏电阻的应用原理及应用范围

 GTO与普通晶闸管相比为什么可以自关断?为什么普通晶闸管不能呢?从GTO原理、应用范围带你了解原因及推荐型号
GTO与普通晶闸管相比为什么可以自关断?为什么普通晶闸管不能呢?从GTO原理、应用范围带你了解原因及推荐型号

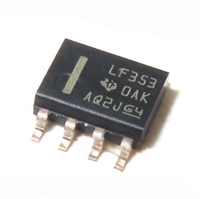 LF353数据手册解读:特性、应用、封装、引脚说明、电气参数及替换型号推荐
LF353数据手册解读:特性、应用、封装、引脚说明、电气参数及替换型号推荐

 A4950资料手册解读:特性、应用、封装、引脚功能、电气参数及代换型号
A4950资料手册解读:特性、应用、封装、引脚功能、电气参数及代换型号
