在电源管理领域,功率MOSFET扮演着至关重要的角色。了解其各项特性对于优化电源设计、提高系统性能和可靠性具有重要意义。本文将以VishaySiE848DF这一采用PolarPAK®封装的N沟道30V沟槽功率MOSFET为例,详细探讨功率MOSFET的重要特性。该MOSFET的封装限制为60A和25°C。
阻断电压
阻断电压BVDSS是可以施加到MOSFET的最大电压。在驱动感性负载时,该电压包括施加的电压以及任何感性感应电压。由于感性负载的特性,MOSFET两端的实际电压可能达到施加电压的两倍。这就要求在设计电路时,必须充分考虑感性负载带来的电压变化,确保所选MOSFET的阻断电压能够满足实际应用的需求。
雪崩特性
雪崩特性决定了MOSFET在雪崩条件下能够承受的能量。当超过最大漏源电压且电流冲过器件时,就会发生雪崩现象。雪崩值越高,表明设备越坚固。然而,雪崩条件可能导致两种故障模式,从而损坏MOSFET。其中,“双极闭锁”是最具破坏性的一种,如果器件电流在其内部器件电阻上引起电压降,就会导致晶体管动作和MOSFET寄生双极结构的闭锁。另一种是热故障模式,当雪崩条件使器件温度升高到其最高结温以上时,就会发生这种情况。Trench技术的雪崩能力接近行业领先的平面技术。为确保良好的性能,该技术中的器件会针对最高结温的单脉冲雪崩能量(EAS)进行全面表征,EAS越高,设备越坚固。部分设备还会根据EAR(重复雪崩能量)进行评级。不过,沟槽技术在提供低导通电阻这一理想特性时,有时会牺牲高雪崩能量。与现有的基准平面技术相比,沟槽功率MOSFET技术的单位面积器件导通电阻降低了15%,但通常伴随着更高的电荷,并且该技术可将导通电阻温度系数降低10%。
导通电阻RDS(on)
对于平面和沟槽MOSFET而言,导通电阻都至关重要,因为它直接决定了功率半导体的功率损耗和发热情况。导通电阻越低,器件的功率损耗就越低,运行温度也会相应降低。在标称工作温度通常超过125°C的应用中,这一特性尤为重要。低导通电阻不仅大大降低了许多应用中的散热要求,减少了零件数量和组装成本,还在很多情况下消除了并联MOSFET以实现低导通电阻的需求,与前几代MOSFET相比,提高了可靠性并降低了整体系统成本。RDS(on)会随着细胞密度的增加而降低,多年来,电池密度从1980年的每平方英寸五十万个左右,增加到平面MOSFET的约800万个,沟槽技术的电池密度约为1200万个或更高。
温度影响
无论是平面还是沟槽型MOSFET,最高结温TJ(max)都是器件本身电气特性以及所采用封装的函数。封装的热特性决定了其从芯片中提取热量的能力,结到环境和结到外壳的热阻是衡量MOSFET提取热量能力的重要指标,数据表通常以°C/W或K/W为单位对热阻进行评级。热阻越低,封装消除热量的效率就越高。在某些情况下,可能需要散热器将器件结温保持在其最大额定值以下。如图6-1所示,展示了VGS=4.5V和10V时RDS(ON)随结温的变化情况,其中VGS是栅源电压。

连续漏极电流
连续漏极电流ID确定了MOSFET驱动特定负载的能力,该值可能会受到MOSFET封装的限制。当MOSFET在脉冲模式下运行时,其漏极电流可以达到其连续额定值的数倍。在脉冲模式下,脉冲宽度和占空比决定了安全的漏极电流和器件功耗。
安全工作区SOA
MOSFET的安全工作区SOA是施加到器件的电压和电流的函数,通常表示为电压和电流的曲线,图中显示的“安全”区域表明在此范围内器件能够正常工作。图6-2是SiE848DF的SOA图。

栅极电荷
MOSFET栅极端上的电荷由其栅极-源极电容决定。栅极电荷越低,就越容易驱动MOSFET。总栅极电荷QG会影响MOSFET的最高可靠开关频率,栅极电荷越低,频率越高。在较高频率下工作允许使用较低值、较小尺寸的电容器和电感器,这对于降低系统成本具有重要意义。不过,低栅极电荷也使得设计人员有时需要在开关频率与EMI考虑之间进行权衡。一些新型沟槽器件通过用新的较小的晶片器件替换较大的晶片,优化后可提供比一些现有的平面技术更低的栅极电荷。图6-3显示了SiE848DF的栅极电荷,单位为nC(纳库仑)。
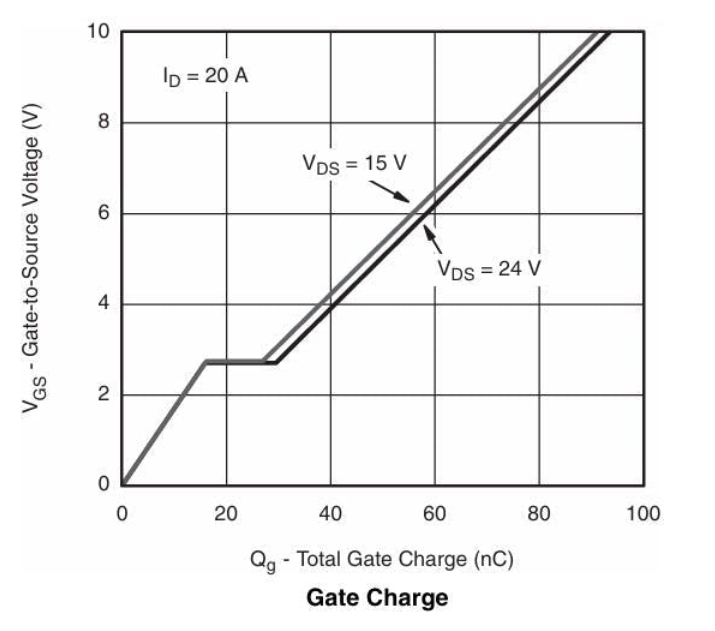
阈值电压
阈值电压Vgs(th)是在源极和漏极区域之间形成导电通道所需的最小栅极-源极偏压,通常在250μA的漏源电流下测量。对于栅极氧化层较厚的高压器件,其值为2-4V;对于栅极氧化层较薄的低电压器件,逻辑兼容值为1-2V。在基于电池的功率敏感应用中,RDS(on)和Vgsth值趋于降低。随着栅极氧化层厚度减小以实现较低的Vgsth,栅极氧化层的质量和完整性成为主要问题,因为这涉及到栅极和源极之间使MOSFET导通的最小电压。逻辑电平MOSFET的典型值约为2V至3V,而其他器件可能具有更高的值。图6-4展示了阈值电压与结温的关系,数据表规定,对于250μA的漏极电流,典型阈值为1.8V,使MOSFET处于逻辑电平范围内。
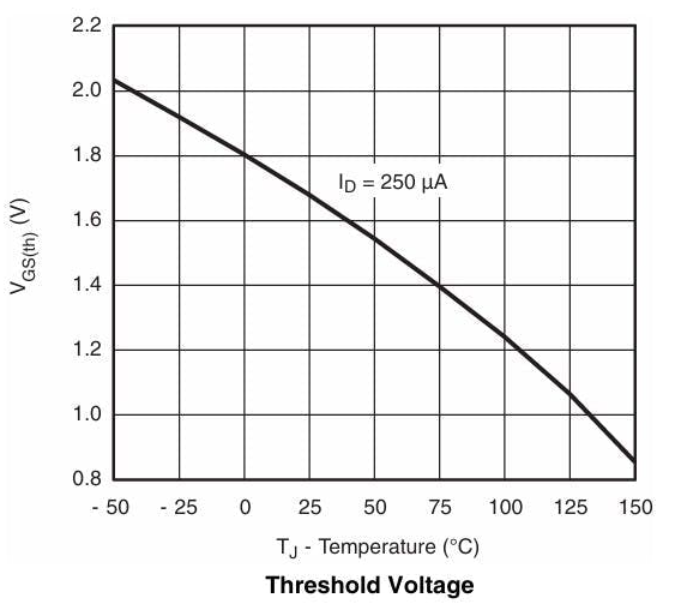
栅极电流计算
尽管输入电容值在一定程度上有用,但在计算给定时间内开关器件所需的栅极电流时并不适用,并且在比较两个器件的开关性能时也不能提供准确的结果。从电路设计的角度来看,总栅极电荷是一个更有用的参数,大多数制造商在其数据表中都会包含这两个参数。利用栅极电荷Qg,设计人员可以根据公式Qg=电流×时间,计算出驱动电路在所需时间内接通器件所需的电流量。例如,如果向栅极提供20mA的电流,栅极电荷为20nC的器件可以在20ms内导通;如果栅极电流增加到1A,则可以在20nsec内导通。而使用输入电容值则无法进行这样简单的计算。
栅极电荷和导通电阻的关系
栅极电荷和导通电阻相互关联,通常栅极电荷越低,导通电阻就越高,反之亦然。过去,MOSFET制造商主要关注降低RDS(on),而对栅极电荷的关注较少。但近年来,随着技术的发展,新的设计和工艺不断涌现,可提供更低栅极电荷的器件。需要注意的是,RDS(on)和栅极电荷之间存在权衡,具体应用将决定哪个参数更为重要。RDS(on)×Qg的乘积是一个品质因数(FOM),可用于比较高频应用中使用的不同功率MOSFET。
损耗情况
由于功率MOSFET主要用作电源开关,因此要求其具有低导通和开关损耗。对于电源管理应用,导通损耗、耐用性和雪崩能力是重要特性。导通损耗由功率MOSFET的工作电流和导通电阻(I²R)的乘积决定。
体二极管正向电压
体二极管正向电压(VSD)是体漏二极管在指定源电流值下保证的最大正向压降。VSD的值在源极-漏极电压可能扩展到负范围的应用中非常重要,必须保持较低水平,以避免体漏二极管正向偏置。如果发生这种情况,源极-漏极电流会从漏极直接流向源极触点,穿过正向偏置体二极管p-n结。当栅源电压VGS>Vgsth,在同步整流器模式下使用低电压和低RDS(on)功率MOSFET时,第二条更主要的电流传导路径将通过通道存在,因为它们的正向压降可以低至0.1V,而典型的肖特基二极管正向压降为0.4-0.5V。对于VSD,高压设备(>100V)的最大值为1.6V,低压设备(<100V)的最大值为1.2V较为常见。图6-5展示了SiE848DF的源极-漏极二极管正向电压。
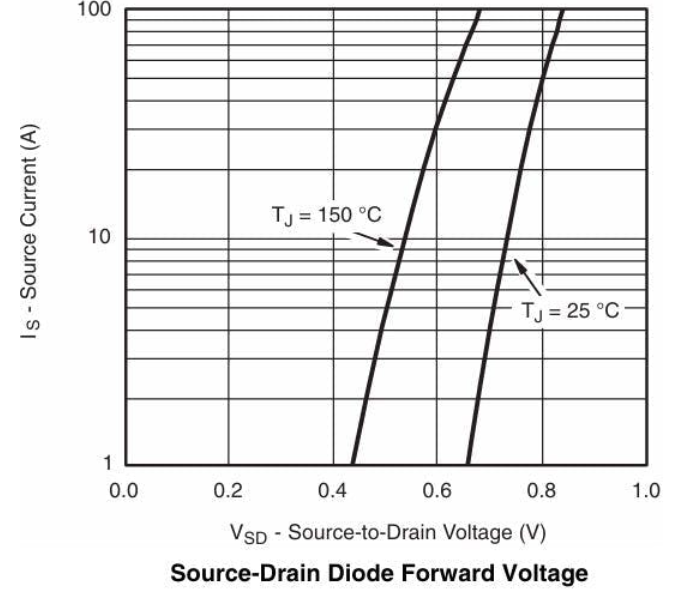
最大允许功率耗散
最大允许功率耗散PD是一个重要参数,当外壳温度保持在25°C时,它会将MOSFET的芯片温度提高到最大允许结温Tjmax,最大Tj通常为150°C或175°C。
热阻
RθJC是MOSFET的结到外壳热阻,典型的表面贴装封装的热阻为30-50°C/W,而典型的TO-220器件的热阻为2°C/W或更低。数据手册还会提供功率MOSFET结到环境热阻的RθJA值。
最大dV/dt
允许的源极-漏极电压的最大上升速率是MOSFET的dV/dt。如果超过此速率,栅源端子两端的电压可能会高于器件的阈值电压,从而迫使器件进入导流模式,在某些情况下可能会发生灾难性故障。导致dV/dt诱导导通有两种可能的机制。一种是通过栅极-漏极电容CGD的反馈作用激活,与CGS一起形成一个电容分压器,在漏极上的快速电压转换期间产生足以超过Vth的脉冲,从而打开器件。当器件的漏极和源极端子上出现电压斜坡时,通常驱动器会吸收流经栅极电阻RG的电流,以在关断状态下将栅极箝位为低电平,但如果Rg太大,有时可能会将驱动器与栅极隔离,从而允许器件导通,这里的RG是电路中的总栅极电阻。另一种机制是通过寄生BJT,与体二极管的耗尽区相关的电容(延伸到漂移区,表示为CDB)出现在BJT的基极和MOSFET的漏极之间,当漏源端子上出现电压斜坡时,该电容会产生流经基极电阻RB的电流。
开关和瞬态响应影响因素
当MOSFET用作开关时,其基本功能是通过施加到栅极的电压信号来控制漏极电流。器件的开关性能取决于确定电容两端的电压变化和电感电流变化所需的时间。RG是栅极的分布电阻,与有源面积大致成反比,RG的乘积和多晶硅栅极的活性面积通常约为20Ω-mm²。功率MOSFET输入中还存在一些寄生效应,Ls和LD分别是源极和漏极引线电感,大约为几十nH,此外还有几个与功率MOSFET相关的寄生电容,例如栅极-源极电容CGS是由于多晶硅栅极与源极和通道区域重叠而产生的电容,它不是外加电压的强函数。
静电影响
MOSFET技术的出现带来了静电这一影响半导体的因素。处理MOSFET半导体的人积累的电荷通常足以破坏零件。因此,半导体制造商制定了3000V至5000V的静电放电额定值。为防止静电问题,MOSFET半导体的处理程序通常会使用接地带和导电表面。
综上所述,全面了解功率MOSFET的各项特性,对于电源管理设计人员优化电路设计、提高系统性能和可靠性具有重要指导意义。在实际应用中,需要根据具体需求综合考虑各个特性,选择最合适的功率MOSFET器件。


 529
529







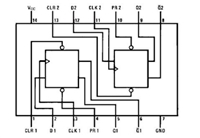




 浙公网安备 33010502006866号
浙公网安备 33010502006866号